Osservazione e misurazione di Ball Grid Arrays (BGA) con un microscopio digitale
La diffusione dei sistemi di comunicazione mobile di quinta generazione (5G) ha fatto sì che i dispositivi a semiconduttore diventassero sempre più piccoli e integrati, aumentando anche la domanda di ispezione e analisi dei prodotti.
Questa sezione introduce esempi di osservazione e misurazione delle protuberanze dei BGA, che sono comuni bersagli di osservazione per i microscopi digitali.
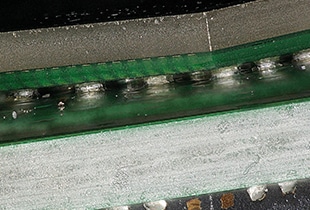
- Pacchetti IC tipici
- Saldatura tipica per il montaggio di chip di circuiti integrati
- Metodi di creazione di protuberanze per l'incollaggio di flip chip
- Esempi di osservazione e misurazione delle BGA (protuberanze) con un microscopio digitale
Pacchetti IC tipici
Man mano che i circuiti integrati diventano sempre più integrati, la tecnologia di montaggio superficiale (SMT) è diventata mainstream. I pacchetti di tipo matrice (tipo BGA) sono utilizzati per circuiti integrati altamente integrati.
Questa sezione presenta i seguenti pacchetti IC tipici.
Tecnologia di montaggio superficiale (SMT): pacchetto di tipo no-lead
- Pacchetto SON (small outline no-lead)
-

Si tratta di pacchetti SMT di tipo no-lead. Gli elettrodi adesivi vengono utilizzati come terminali di collegamento. I SON sono pacchetti di tipo bidirezionale utilizzati per un numero ridotto di pin.
- Pacchetto QFN (quad flat no-lead)
-

Si tratta di pacchetti SMT di tipo no-lead. Gli elettrodi adesivi vengono utilizzati come terminali di collegamento. I QFN sono pacchetti a quattro vie.
Tecnologia di montaggio superficiale (SMT): pacchetto a matrice
- BGA (ball grid array)
-

Le sfere di saldatura sono disposte sul fondo del pacchetto per essere utilizzate come terminali.
- PGA (pin grid array)
-

I pin sono disposti sul fondo del pacchetto per essere utilizzati come terminali.
- LGA (land grid array)
-

I pad degli elettrodi (compresi quelle in rame) sono disposti sul fondo del pacchetto per essere utilizzati come terminali.
Saldatura tipica per il montaggio di chip di circuiti integrati
- Saldatura dei fili
-
Il wire bonding viene utilizzato per collegare gli elettrodi dei chip dei semiconduttori ai conduttori elettrici dei lead frame o delle schede con fili sottili di oro, alluminio o rame.

- Saldatura di flip-chip
-
Il metodo in cui i chip di circuiti integrati vengono fissati direttamente a una PCB è chiamato FC-BGA (Flip Chip-BGA). Le protuberanze vengono realizzate sugli elettrodi di un chip IC e poi collegate agli elettrodi di un PCB. In questo modo si risparmia spazio rispetto al wire bonding.

- A sinistra: chip di circuiti integrati
- A destra: capovolgimento (a faccia in giù)
Metodi di creazione di protuberanze per l'incollaggio di flip chip
- Montaggio della sfera a saldare
- Le sfere di saldatura vengono realizzate in anticipo, posizionate sugli elettrodi e quindi sottoposte a rifusione per ottenere le protuberanze. È possibile realizzare protuberanze più alte di quelle possibili con la stampa in pasta. Unificando le dimensioni delle sfere di saldatura si evitano anche le differenze di altezza delle protuberanze.
- Stampa in pasta
- La pasta saldante viene stampata sugli elettrodi e poi rifusa per creare le protuberanze. La produttività è elevata, ma è difficile unificare l'altezza delle protuberanze.
- Placcatura
- L'elettroplaccatura viene utilizzata per realizzare le protuberanze di saldatura. È possibile realizzare protuberanze fini, ma la produttività è bassa.
Esempi di osservazione e misurazione delle BGA (protuberanze) con un microscopio digitale
Di seguito vengono presentati gli ultimi esempi di immagini di osservazione e misurazione di BGA (protuberanze) utilizzando il microscopio digitale 4K della Serie VHX di KEYENCE.
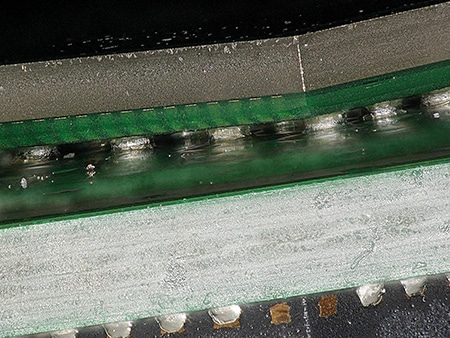
100×, illuminazione anulare
L'osservazione inclinata consente di osservare le sfere BGA attraverso uno spazio libero su una PCB.
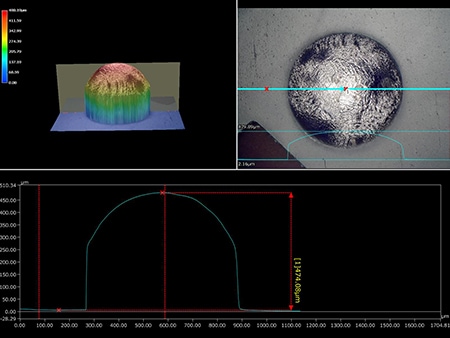
300×, illuminazione mista (immagine di rimozione dei bagliori)
L'illuminazione mista e la funzione di rimozione dei bagliori consentono di osservare senza bagliori.